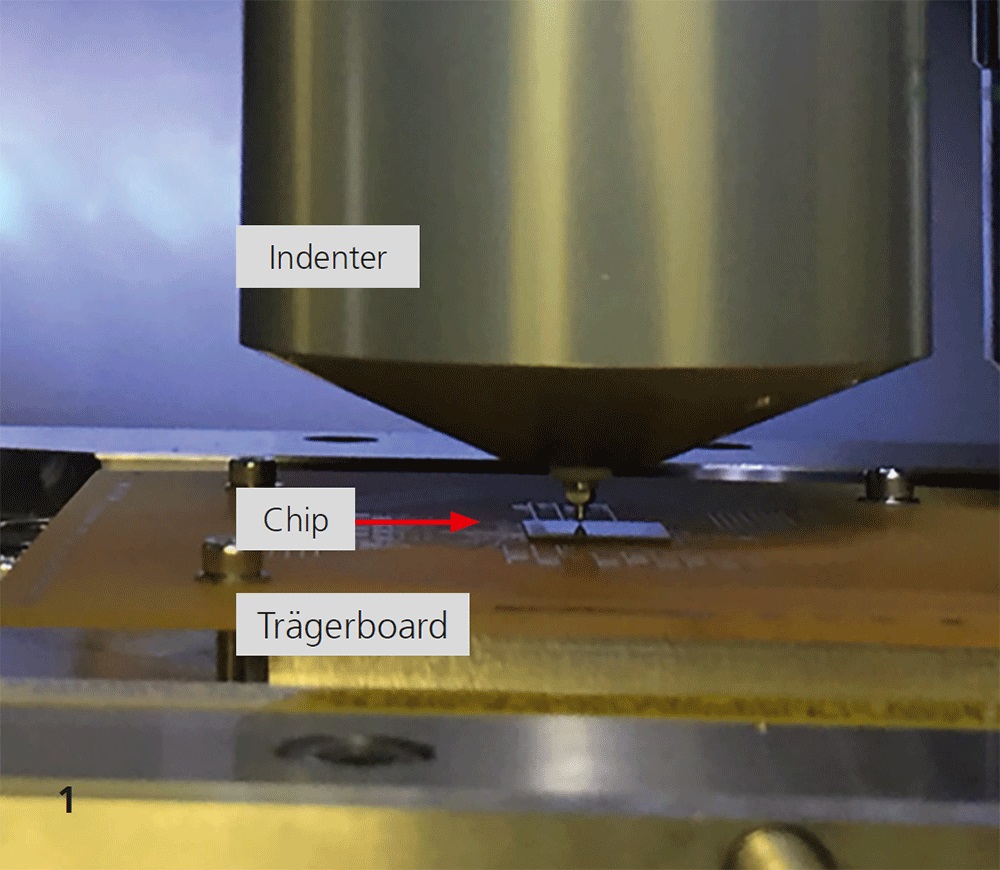

Spannungseffekte in Transistoren
In modernen Mikroelektronik-Technologien werden lokale Spannungen in das Silicium eingebracht, um deren Leistung und Effizienz zu optimieren. Der sogenannte piezoresistive Effekt sorgt dabei für eine Verbesserung der elektrischen Eigenschaften. Auf der anderen Seite können unkontrollierte mechanische Spannungen, wie sie z. B. in anspruchsvollen Umgebungen wie im Automobil auftreten, die Funktionalität und Zuverlässigkeit von Mikroelektronik-Bauteilen negativ beeinflussen. Eine etablierte Methode zur Abschätzung des Einflusses von mechanischen Spannungen ist die Vier-Punkt-Biegung. Damit lassen sich jedoch nur homogene globale Spannungen aufbringen. Um den lokalen Einfluss von Spannungen mit hoher Ortsauflösung zu bestimmen, wurde am Fraunhofer IKTS eine Technik zur punktuellen Einbringung von Spannungen mittels Indentation entwickelt und erfolgreich umgesetzt.
Zerstörungsfreie Indentation auf Test-Chips
Für die Untersuchungen werden Test-Chips mit integrierten spannungssensitiven Schaltkreisen (Ringoszillatoren) genutzt, die ihrerseits auf einem Trägerboard verlötet sind. Mit diesem Aufbau kann das Verhalten der elektrisch aktiven Schaltkreise inklusive deren Transistoren unter lokaler mechanischer Belastung analysiert werden. Dazu belastet ein Indenter mit kugelförmiger Spitze die Test-Chips auf der Siliciumseite zerstörungsfrei (Bild 1). Parallel werden die charakteristischen Signale der Schaltungen (Frequenz f) bei stetig erhöhter mechanischer Belastung kontinuierlich elektrisch ausgelesen (Bild 2). Über mechanische Simulationen (FEM) des Versuchsaufbaus werden aus den experimentell eingeleiteten Kraftwerten Spannungswerte in den Transistorkanälen der Schaltkreise bestimmt. Diese mechanischen Kenngrößen stellen die physikalische Ursache für die Parametervariation der Transistoren dar.
Es wurden zwei unterschiedliche Ringoszillator-Typen (NAND-und NOR-Schaltkreise) untersucht. Diese zeigten im Experiment deutlich unterschiedliche Reaktionen auf die eingeleiteten Spannungen, was sich auf deren spezifische Schaltkreis-Layouts zurückführen lässt. Im Weiteren wurden Genauigkeit, Auflösung sowie Einfluss relevanter Parameter untersucht und verbessert. Aufbauend auf diesen Ergebnissen konnte auch der richtungsabhängige Einfluss von Spannungen auf die Transistorfunktionalität mit Zylinder-Spitzen experimentell bestimmt werden. Eine Kombination der Ergebnisse aus Kugel- und Zylinderkontakt-Experimenten ermöglichte zudem die quantitative Bestimmung der Matrix der piezoresistiven Koeffizienten der Test-Chip-Technologie, was ein herausragendes Ergebnis für die industrielle Nutzung des Verfahrens darstellt. Mit Hilfe des entwickelten Verfahrens können nun lokale Einflüsse von verspanntem Silicium sowie unkontrollierte Spannungen auf die Bauteile abgeschätzt werden.
