
Neue Ansätze für In-situ-Analytik in der Mikroelektronik
Forschung aktuell

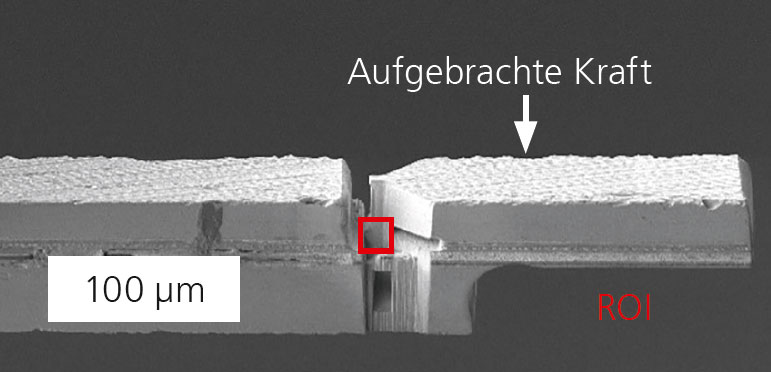
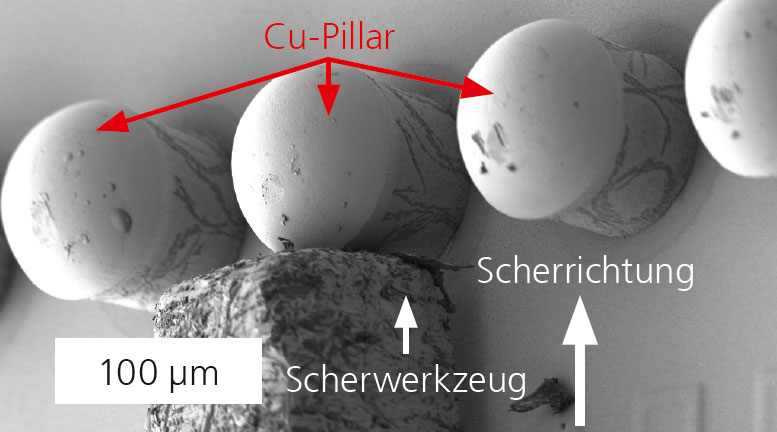
3D-Nanoröntgentomographie von μ-Rissen in Mikrochip-Verdrahtungsebenen
On-chip-Verdrahtungsebenen (Back-End of Line: BEoL) von Mikroelektroniktechnologien bestehen aus immer feineren Strukturen unter-schiedlichster Materialien, wie Kupfer oder nanoporösen Dielektrika. Das führt zu größeren Herausforderungen an deren mechanische Stabilität und damit deren Zuverlässigkeit unter verschiedensten Lasten, wie Chip Package Interaction (CPI). Neue Methoden zur Untersuchung dieser feinen Strukturen sind die Röntgenmikroskopie und die darauf aufbauende 3D-Nano-Röntgentomografie (nanoXCT). Letztere eignet sich mit ihrer Auflösung von 50 nm perfekt für in-situ nanoXCT-Rissexperimente zur Analyse von Schwachstellen im BEoL. Bild 1 zeigt eine mittels PlasmaFIB hergestellte komplexe Hebel-basierte Push-to-pull-Probe, die in der nanoXCT einen Riss in der region of interest (ROI) im BEoL unter Zugbelastung einbringt. Während des Experiments kann die Rissausbreitung in der ROI mit hoher Auflösung in 2D und 3D beobachtet und verstanden werden. Auf Basis solcher komplexen nano-mechanischen in-situ nanoXCT-Workflows können zukünftig stabilere Mikrochip-Technologien für herausfordernde Anwendungen wie den Automobilbau entstehen.
Rissidentifizierung in Back-End of Line (BEoL)-Stacks
In der Industrie ist die Untersuchung der Stabilität von on-chip Lötkugeln (solder bumps) und Kupfer-Pillar-Geometrien bereits etabliert. Speziell jedoch für die darunter liegenden rissgefährdeten BEoL-Stacks existieren kaum vergleichbare Standards. Am Fraunhofer IKTS wurde nun eine Methode adaptiert, um die Rissentstehung und -ausbreitung in Kupfer- Pillar/BEoL-Systemen zu beobachten. Zunächst werden zur Bewertung der mechanischen Stabilität von BEoL-Stacks externe Kräfte auf die Kupfer-Pillar ausgeübt. Dies erfolgt durch Scherbelastung mit einem in-situ (Bild 2) oder ex-situ Nanoindenter-System (Bild 3a). Ein an der Probe angebrachter Sensor erkennt akustische Emissionen (AE) und misst so während des Scherexperiments akustische Wellen, die auf eine Schädigung hinweisen (Graphik). Die viel höhere zeitliche Auflösung der AE-Messungen im Vergleich zu den Piezosensoren des Indenters ermöglicht einen genaueren Einblick in den Schädigungsprozess. Anschließend werden die entstandenen Schäden mit den Methoden der Nanoanalytik, wie der Nano- Röntgen-Computertomographie (nanoXCT, Bild 3b, c) und der Rasterelektronenmikros-kopie (REM, Bild 2) weiterführend untersucht. Die Ergebnisse erlauben ein besseres Verständnis des Ursprungs und der Ausbreitung von Schäden im BEoL-Stapel. Die nanoXCT-Schadensanalyse des in den Bildern dargestellten Beispiels zeigt, dass der BEoL-Stack nicht nur lokal delaminiert, sondern dass sich Risse horizontal entlang der Schichten ausbreiten, die mit anderen optischen Messmethoden nicht nachweisbar wären. Genauere Einblicke in das Rissverhalten bieten zusätzliche in-situ Scherversuche an Kupfer-Pillar in der nanoXCT und im SEM.
Diese Untersuchungen werden zukünftig die Analyse von BEoL-Strukturen ergänzen und die Rissausbreitung exakter charakterisieren. Das bringt entscheidende Vorteile für die Zuverlässigkeitsbewertung.