
Multiskalige 3D-Analytik, Datenkorrelation und Präparation in der Halbleiterentwicklung
Forschung aktuell

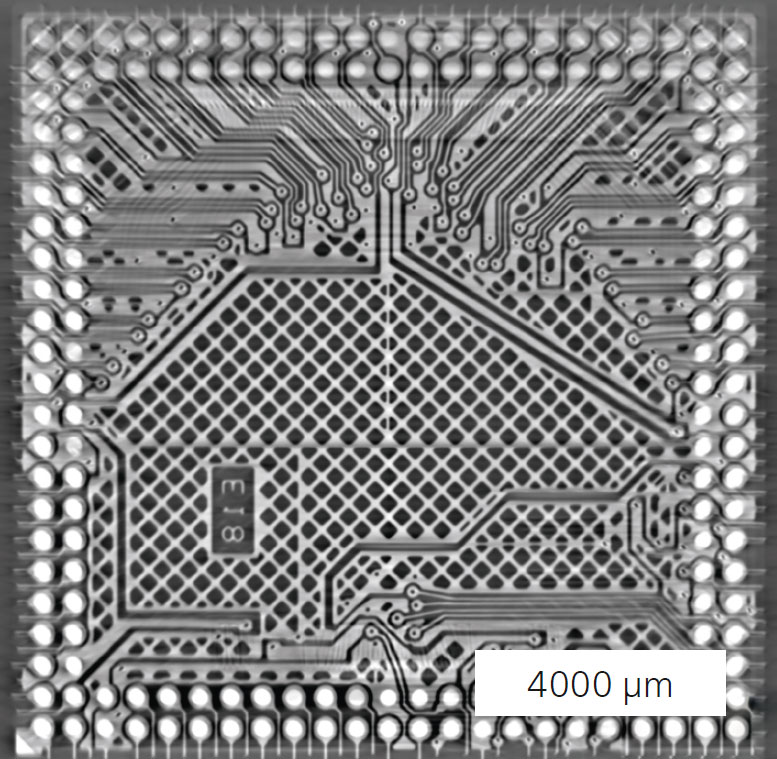

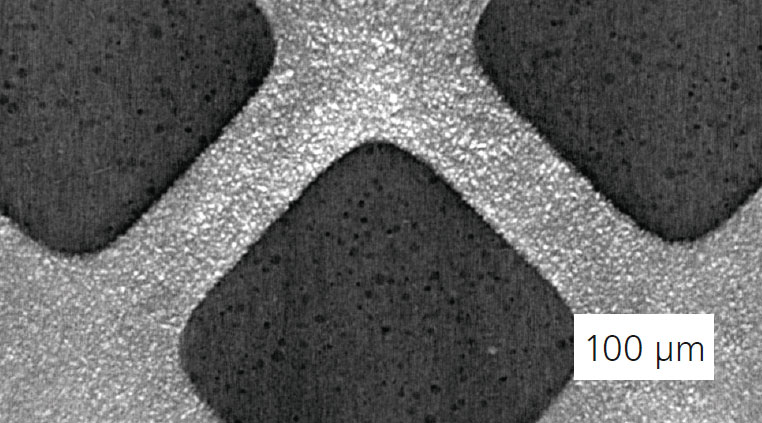
Das Fraunhofer IKTS bietet analytische und präparative Workflows zur skalenübergreifenden, multimodalen Analytik für die Entwicklung von Materialien, Komponenten und Bauelementen der Mikro- und Leistungselektronik mit dem Ziel der beschleunigten Optimierung. Die Präparation erfolgt bei Bedarf inert und gekühlt (Flüssigstickstoff). Die Analytik beinhaltet Mikroskope (2D), die mit Elektronen Ionen und Licht (auch Röntgen) abbilden sowie Röntgentomographen (3D). Diese Geräte sind mit operando-Modulen zur mechanischen Testung (z. B. Zug/Druck, Biegung, Haftung) ausgestattet. Die Gesamtheit aller so erzeugten Daten wird FAIR (findable, accessible, interoperable, reachable) abgelegt und zur korrelativen, quantitativen und statistischen Auswertung auch mit Methoden des maschinellen Lernens genutzt und dem Kunden bereitgestellt.
Zerstörungsfreie Volumenanalyse
Integrierte Halbleiterbauelemente (Bilder 1–4) können mittels Röntgenmikroskopie (XRM) tomographisch untersucht werden. Hier stehen verschiedene Geräte zur Verfügung, die mit 3D-Volumen-Pixeln (sogenannten Voxeln) von wenigen Nanometern bis einigen 10 μm Auflösung arbeiten. Im Kontrast erscheinen insbesondere die stark absorbierenden metallischen Leiterbahnen und vertikalen Kontakte. Etwaige Defekte wie schadhafte Metallisierungen können so im Volumen identifiziert und lokalisiert werden. Im Anschluss kann eine Zielpräparation zu den Defekten erfolgen und mit nachgeschalteter Analytik weiter untersucht werden.
Probenzielpräparation
Mikro- und Nano-Analytik erfordert meist dedizierte Probenzielpräparation, die vollumfänglich am Fraunhofer IKTS vorhanden ist und der Analytik entlang der Prozesskette zur Seite steht. Mittels Laserablation, mechanischer Politur (TXP) und Ionenätzen (TIC3X) können sowohl Verkapselungen von Bauelementen entfernt werden als auch ein schonendes Freilegen innerer Oberflächen erfolgen. Eine nanometergenaue finale Präparation erfolgt im Zweistrahl Rasterelektronen-Ionenmikroskop (FIB-SEM) für das Gallium-, Helium- und Neon- Ionen zur Verfügung stehen.
Skalenübergreifende, multi-modale und korrelative Analyse und Datenkorrelation
Mit analytischer Mikroskopie (Kompositionsbestimmung mit energiedispersiver Röntgenanalyse – EDX) und Spektroskopie (z. B. molekulares Fingerprinting mit Raman-Spektroskopie und Flugzeit-Massenspektroskopie – TOF-MS bei Ionenstrahlmaterialabtrag im FIB-SEM) kann ein umfassendes Bild über Morphologie und multi-physikalische Eigenschaften von Proben erzeugt werden. Im Rahmen der Zuverlässigkeitsanalyse werden am IKTS analytische Mikroskopie in FIB-SEMs inklusive Element- und Kristallanalytik und elektrische Fehleranalyse mit Rastersondenverfahren kombiniert mit mechanischen Tests (im FIB-SEM und XRM). Dank der nanoGPS-Technologie [1] kann eine Relokalisation mit μm-Genauigkeit identischer Probenstellen in den verschiedenen Messmodalitäten erreicht werden. Die komplexen, sehr großen Datensätze (für XRM z. B. >15 GB pro Datensatz) werden mit KI-gestützten Methoden automatisiert, quantitativ und statistisch ausgewertet.
Literatur
[1] O. Acher et al., Meas. Sci. Technol. 32, 045402 (2021).