

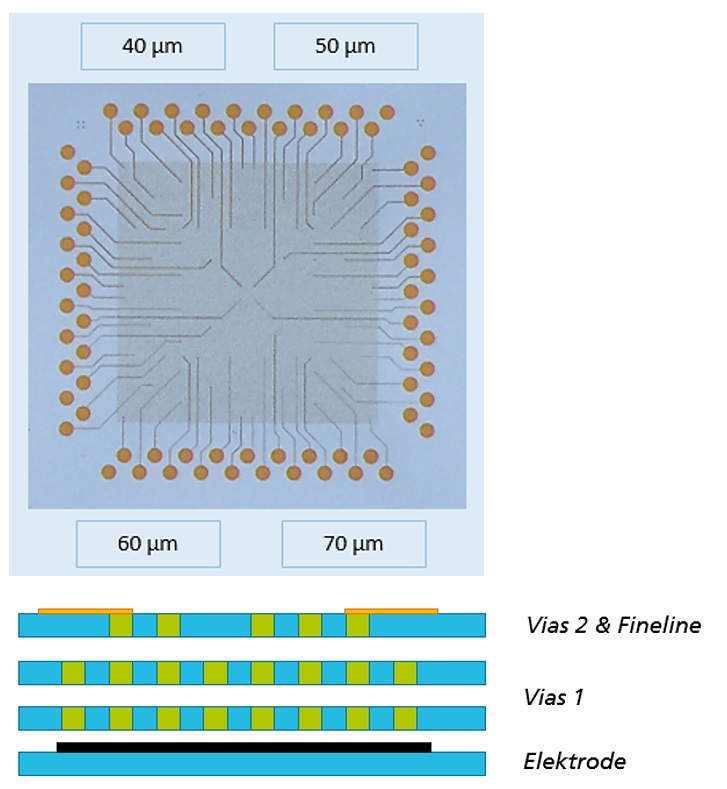
Mehrlagenkeramische Verdrahtungsträger höchster Verdrahtungsdichte in LTCC-Technologie
Verdrahtungsträger sind mechanische Träger, auf denen Leitungsstrukturen zur Verdrahtung elektronischer Bauelemente aufgebracht sind. Neben der elektrischen Verbindung funktionaler (mikroelektronischer) Komponenten haben sie eine Stützfunktion, eine thermische Funktion (Wärmeabführung) und eine schirmende Funktion (Atmosphäre, Partikel, elektromagnetische Strahlung). Eine grundsätzliche Unterscheidung der Verdrahtungsträger ist in Einebenenträger, Zweiebenenträger, Mehrlagenverdrahtungsträger und Mehrschichtverdrahtungsträger möglich. Als Fertigungstechnologien dieser Komponenten kann die Leiterplattentechnik (starr/flexibel), die Dickschichttechnik und die Mehrlagenkeramiktechnologie eingesetzt werden.
Mehrlagenkeramische Verdrahtungsträger bieten gegenüber den Alternativtechnologien folgende Vorteile:
- Hohe Verdrahtungsdichten (Anzahl Leiterzüge pro Substratfläche) durch hochauflösende dickschichtbasierte Druckverfahren, hochminiaturisierte elektrische Durchkontaktierungen und Verdrahtung auf mehreren Ebenen (F & E > 40 Layer)
- Hohe Packungsdichte (Montagefläche montierter Bauelemente pro Substratfläche) durch Integration passiver Komponenten (R, L, C) in die Innenlagen des Mehrlagensubstrates
- Stabilität unter hohen mechanischen Belastungen wie Vibration und Schock
- Thermomechanische Anpassung des Keramiksubstrates an siliziumbasierte Bauelemente (hohe Zuverlässigkeit bei thermischen Zyklen)
- Optimale Entwärmung leistungselektronischer Bauelemente aufgrund guter Wärmeleitfähigkeit der Keramik in Kombination mit ausgezeichneter Stabilität bei höheren Temperaturen
- Echte Hermetische Abschirmung empfindlicher Elektronik durch Abdeckungen/Verschlusskappen in Kombination mit Fügeverfahren auf Basis anorganischer Werkstoffe
Gegenwärtige Entwicklungen des Fraunhofer IKTS haben das Ziel, die aktuellen Verdrahtungsträgerdichten der LTCC-Technologie durch Einsatz neuartiger Strukturierungs- und Abscheideverfahren zu erhöhen. Entwurfsregeln kommerzieller mehrlagenkeramischer Hersteller weisen minimale Linienbreiten und Abstände (Line/Space) von 0,1/0,1 mm aus, während minimale Durchmesser von Durchkontaktierungen mit 0,15 mm angegeben werden.
Durch den Einsatz fortschrittlicher Stanztechnologien zur Strukturierung von Via-Öffnungen in keramischen Grünfolien sind kleinste Durchmesser bis 0,1 mm zuverlässig realisierbar. Die Verwendung von Laserprozessen gestattet eine weitere Miniaturisierung der Via-Durchmesser bis 0,06 mm. Das Füllen derart miniaturisierter Vias ist durch rheologische Adaption der zur Durchkontaktierung verwendeten Dickschichtpasten und durch Anpassung der Schichtabscheidungstechnologie erfolgreich umsetzbar.
Eine Modifikation der Siebdruckpasten und der Einsatz von Fine- Line-Siebdrucktechnologien erlaubt das Abscheiden hochaufgelöster Leiterbahnstrukturen auf grünkeramischen Folien. Auf Basis dieser Technologien lassen sich minimale Linienbreiten von 0,04 mm bei einer Substratgröße von 4“x4 realisieren.
Zur Veranschaulichung dieser technologischen Möglichkeiten wurde ein Demonstrator aufgebaut.